Ионная имплантация
Ионной имплантацией принято называть легирование тонких приповерхностных слоев твердого тела путем облучения поверхности пучком ионов, ускоренных до энергии 104-106 эВ. Первые публикации по этой тематике датированы началом 60-х годов и речь тогда шла о легировании полупроводников. Это направление доминировало вплоть до начала 80-х годов, когда параллельно с ним появилась и за несколько лет сформировалась новая ветвь исследования и технологии, получившая в последние годы название “имплантационная металлургия”.
Универсальность ионной имплантации (и по виду легирующего вещества, и по виду легируемого материала) на начальном периоде “малых доз” позволяла не ограничивать себя ни физическими, ни экономическими соображениями и пытаться применить ее всюду, где есть твердое тело и необходимость как-то изменить свойства его поверхностного слоя. На фоне колоссального расширения фронта работ до поры до времени можно было не замечать отдельных неудач в применении ионной имплантации к тем или иным системам и тут же переходить к другим задачам. Позже, когда бум “Имплантация может все!” сменился более углубленным и серьезным анализом, начали проясняться некоторые физические ограничения имплантационного метода. Этот процесс начался, когда, с одной стороны, стали пытаться для получения тех же результатов пробовать другие, альтернативные методы, а с другой стороны, началась “гибридизация” имплантационной методики с традиционными технологиями.
Переход имплантационной технологии из лабораторий в промышленность ввел в действие мощный экономический фактор оценки - производительность и стоимость операции. Особенно остро этот вопрос встал именно в связи с “имплантационной металлургией” или имплантацией больших доз, где решающим фактором стоимости всей технологии становится производительность имплантационного оборудования. Даже в полупроводниковой технологии, где размеры обрабатываемой поверхности незначительны, длительность и стоимость операции легирования эмиттерных слоев на стандартном имплантационном оборудовании оказалась непомерно высокой; для потребностей же машиностроения эта проблема усугубляется и масштабом производства, и дешевизной остальных операций технологической цепочки.
В связи с этим возникает настоятельная необходимость провести сравнительный анализ основных технологий модификации поверхностных слоев, высветить физические ограничения ионной имплантации и альтернативных технологий применительно к конкретным задачам науки и техники, а также провести ориентировочную экономическую оценку этих технологий и перспективы их освоения в той или иной области промышленности. Этому и посвящена настоящая работа.
1. Сущность и назначение ионной имплантации
Ионная имплантация - это процесс, в котором практически любой элемент может быть внедрен в приповерхностную область любого твердого тела - мишени, помещенной в вакуумную камеру, посредством пучка высокоскоростных ионов с энергией до нескольких мегаэлектронвольт. Имплантируемые ионы внедряются в материал мишени на глубину от 0,01 до 1 мкм, формируя в ней особое структурно-фазовое состояние. Толщина слоя зависит от энергии и от массы ионов и от массы атомов мишени.
Так как технология имплантационного модифицирования позволяет внедрить в поверхность заданное количество практически любого химического элемента на заданную глубину, то таким образом можно сплавлять металлы, которые в расплавленном состоянии не смешиваются, или легировать одно вещество другим в пропорциях, которые невозможно достичь даже при использовании высоких температур. Следовательно, оказалось возможным создавать композиционные системы с уникальными структурами и свойствами, существенно отличными от свойств основной массы детали.
Как объект атомно-физических исследований ионная имплантация впервые сформировалась в начале 60-х годов. Это стало возможным благодаря достижениям в области изучения ядерных взаимодействий; основным оборудованием для ионного легирования является ускоритель. Энергия ионов может изменяться (в зависимости от свойств материалов комбинации ион - мишень) от нескольких килоэлектронвольт (кэВ) до нескольких мегаэлектронвольт (МэВ). Введение импланта в основную решетку поверхности изделия возможно без “соблюдения” законов термодинамики, определяющих равновесные процессы, например, диффузию и растворимость.
Ионная имплантация приводит к значительному изменению свойств поверхности по глубине:
Ø слой с измененной дислокационной структурой до 100 мкм.
Успешное применение ионной имплантации определяется главным образом возможностью предсказания и управления электрическими и механическими свойствами формируемых элементов при заданных условиях имплантирования.
Наиболее распространенным применением ИИ в технологии формирования СБИС является процесс ионного легирования кремния. Часто приходится проводить имплантацию атомов в подложку, которая покрыта одним или несколькими слоями различных материалов. Существование многослойной структуры способно вызвать резкие перепады в профиле легирования на границе отдельных слоев. За счет столкновения ионов с атомами приповерхностных слоев последние могут быть выбиты в более глубокие области легируемого материала. Такие "осколочные эффекты" способны вызвать ухудшение электрических характеристик готовых приборов.
Общая траектория движения иона называется длиной пробега R, а расстояние, проходимое внедряемым ионом до остановки в направлении, перпендикулярном к поверхности мишени, проецированной длиной пробега Rp.
2. Схема установки
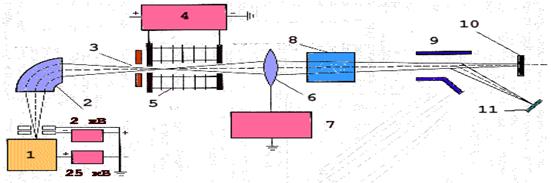
Рис. 1. Схема установки для ионной имплантации
Схема установки для ионной имплантации приведена на рис. 1.
1 - источник ионов
2 - масс-спектрометр
3 - диафрагма
4 - источник высокого напряжения
5 - ускоряющая трубка
6 - линзы
7 - источник питания линз
8 - система отклонения луча по вертикали и система отключения луча
9 - система отклонения луча по горизонтали
10 - мишень для поглощения нейтральных частиц
11 – подложка
Магнитный масс-спектрометр предназначен для отделения ненужных ионов от легирующих, электрометр - для измерения величины имплантированного потока ионов. Маски для ИИ могут быть изготовлены из любых материалов, используемых в технологии СБИС (фоторезист, нитриды, окислы, поликремний).
Управление дозой при ИИ затруднено рядом факторов. Это наличие потока нейтральных частиц, обмен энергии ионов с молекулами газов, вторичная электронная эмиссия из мишени, эффект обратного ионного распыления. Для ликвидации последствий действия этих факторов используют следующие технические приемы. Нейтральные молекулы отсеивают с помощью масс-спектрометра (его магнитным полем не отклоняет нейтральные частицы и они не попадают в апертурную диафрагму). Кроме того, в камере поддерживается достаточно высокий вакуум, предотвращающий процесс нейтрализации ионов. Вторичную электронную эмиссию подавляют, располагая около мишени ловушку Фарадея.

Рис. 2. Профиль распределения примеси при ионной имплантации бора различных энергий в кремний
Профиль распределения примеси при ионной имплантации бора различных энергий в кремний приведен на рис. 2. Для корректного теоретического расчета профиля, особенно для больших значений энергий пучков ионов, используют два объединенных распределения Гаусса
 ,
,
Где D - поглощенная доза,
Rm - модальная длина пробега (аналог проекционной длины пробега при Гауссовском распределении),
DR1, DR2 - флуктуации первого и второго распределения,
DRi=DR1 при x>Rm,
DRi=DR2 при x<=Rm.
Теоретические профили, рассчитанные по приближению Пирсона с 4 параметрами и распределению Гаусса, и измеренные профили при ионной имплантации бора в кремний без проведения отжига приведены на рис. 3.
3. Основные характеристики ионной имплантации
Формально ионной имплантацией следовало бы называть облучение поверхности твердого тела атомами или атомарными ионами с энергией не менее 5-10 энергий связи атома в решетке облучаемой мишени (тогда до остановки ион или атом пройдет не менее 2-3 межатомных расстояний, т.е. внедрится, “имплантируется” в объем мишени). Будем, однако, по традиции термином “ионная имплантация” называть здесь более узкий диапазон энергий - от 5-10 кэВ до 50-100 кэВ (это связано и с историей развития метода, и с особенностями оборудования, на котором реализуется облучение, да и с тем, что для других энергий ионов уже практикуются иные наименования процесса). И с самого начала сложилась такая ситуация, что исследователи ионной имплантации декларировали (имея на это достаточно оснований) следующий ряд достоинств легирования методом ионной имплантации (или имплантационного легирования):
1. Возможность вводить (имплантировать) любую примесь, любой элемент Таблицы Менделеева.
2. Возможность легировать любой материал.
3. Возможность вводить примесь в любой концентрации независимо от ее растворимости в материале подложки.
4. Возможность вводить примесь при любой температуре подложки, от гелиевых температур до температуры плавления включительно.
5. Возможность работать с легирующими веществами технической чистоты и даже с их химическими соединениями (тоже любой чистоты).
6. Изотопная чистота легирующего ионного пучка (т.е. возможность легировать не только исключительно данным элементом, но и исключительно данным изотопом этого элемента).
7. Легкость локального легирования (с помощью хотя бы элементарного механического маскирования).
8. Малая толщина легированного слоя (менее микрона).
9. Большие градиенты концентрации примеси по глубине слоя, недостижимые при традиционных методах с неизбежным диффузионным размыванием границы.
10. Легкость контроля и полной автоматизации технологического процесса.
11. Совместимость с планарной технологией микроэлектроники.
К настоящему времени эйфория абсолютизации этих достоинств прошла, более или менее определенно сформировались области их наиболее выпуклого проявления, но также и области, где они перестают действовать (ниже об этом будет сказано подробнее). В каждом конкретном случае применения ионной имплантации на первый план выступают те или иные особенности процесса, те или иные физические эффекты, сопутствующие имплантации. Поэтому полезно напомнить перечень основных физических эффектов, существенных при имплантационном легировании (см. табл. 1).
Исследование этих эффектов позволило добиться значительных успехов в использовании ионной имплантации для решения научных задач по целому ряду направлений, как фундаментальных, так и прикладных. Основные области науки, где ионная имплантация стала мощным инструментом исследований, перечислены в Таблице 2, а в Таблице 3 показано, какие из физических эффектов ионной имплантации являются ключевыми при использовании в каждой из этих областей науки.
Таблица 1. Основные физические эффекты, сопровождающие ионную имплантацию.
| Индекс эффекта | Наименование физического эффекта | |
| 1 | Химическое легирование | |
| 2 | Нарушение кристаллической структуры материала мишени | |
| 2.1 | Нарушение стехиометрии материала мишени | |
| 3 | Радиационное стимулирование процессов | |
| 3.1 | Стимулирование дефектообразующей радиацией | |
| 3.2 | Стимулирование неразрушающей радиацией | |
| 3.3 | Постимплантационное стимулирование | |
| 4 | Геттерирование дефектов и подвижных примесей | |
| 5 | Механические напряжения | |
| 6 | Образование макроскопических дефектных структур | |
| 7 | Фазовые переходы | |
| 8 | Диффузионные эффекты | |
| 8.1 | Диффузионное перераспределение примеси | |
| 8.2 | Диффузия дефектов | |
Таблица 2. Перечень основных научных направлений, где используется ионная имплантация
| Индекс направления | Наименование области науки | |
| 1 | Физика взаимодействия быстрых атомных частиц с твердым телом | |
| 1.1 | Физика движения быстрых частиц в твердом теле | |
| 1.2 | Физика дефектообразования в твердом теле | |
| 2 | Физика твердого тела | |
| 2.1 | Физика фазовых переходов | |
| 2.2 | Исследование радиационно-стимулированных процессов | |
| 3 | Физика, химия и механика поверхности | |
| 3.1 | Катализ | |
| 3.2 | Внешняя электронная эмиссия | |
| 3.3 | Коррозионная стойкость, пассивация | |
| 3.4 | Физика усталости материалов | |
| 3.5 | Износостойкость | |
| 3.6 | Антифрикционные свойства поверхности | |
| 4 | Физика полупроводников | |
| 4.1 | Физика p-n-перехода | |
| 4.2 | Физика сильнолегированных слоев полупроводника | |
| 4.3 | Физика полупроводниковых приборных структур | |
Анализируя содержимое Таблицы 3, нетрудно усмотреть, что в большинстве задач при использовании ионной имплантации практически “работает” лишь малая часть того набора физических эффектов, которые определяют результат имплантационного легирования. Этот факт наводит на мысль, что можно для тех же целей использовать другие процессы и методики, или более простые, или более дешевые, или более производительные, или просто более доступные в конкретной ситуации. И наконец, следует отметить, что существуют методики, обладающие, кроме перечисленных в Таблице 1 свойств, еще и другими свойствами, полезными применительно к некоторым конкретным задачам.
Таблица 3. Роль различных физических эффектов ионной имплантации в работах по научным направлениям, перечисленным в Таблице 2.
| Индекс физэффекта имплантации | Индекс научного направления | ||||||||||||
| 1.1 | 1.2 | 2.1 | 2.2 | 3.1 | 3.2 | 3.3 | 3.4 | 3.5 | 3.6 | 4.1 | 4.2 | 4.3 | |
| 1 | - | - | + | - | + | + | + | + | + | + | + | + | |
| 2 | + | + | + | - | + | + | + | + | + | ||||
| 3.1 | - | + | + | + | + | + | - | - | - | - | |||
| 3.2 | - | + | + | + | - | - | - | - | - | - | - | - | - |
| 3.3 | - | + | + | + | - | - | - | - | - | - | - | - | - |
| 4 | - | + | + | + | + | - | + | - | - | + | - | + | |
| 5 | - | + | + | - | - | - | - | + | + | + | - | - | - |
| 6 | + | + | - | - | - | - | - | + | + | - | - | - | + |
| 7 | - | + | + | + | + | + | + | - | + | + | + | - | - |
| 8.1 | - | - | + | - | + | + | + | - | + | + | + | + | + |
| Исследование смены режимов течения. Определение критических чисел Рейнольдса Кинетические уравнения Власова Кола з розподіленими параметрами Неоценимый вклад ученых-физиков СССР в Великую Победу Однофазный асинхронный двигатель
Актуально:
| |||||||||||||